プラズマFIB加工によるSiCデバイスの拡散層観察Observation of Diffusion Layer of SiC Device by Plasma FIB Processing
当社で所有するプラズマFIB〔TESCAN SOLARIS X(Xeビーム加工)〕を用いたGaフリー加工において、SiC拡散層観察での有用性が確認できました。へき開では難しい特定箇所観察への応用が期待できます。
当社で所有するプラズマFIB〔TESCAN SOLARIS X(Xeビーム加工)〕を用いたGaフリー加工において、SiC拡散層観察での有用性が確認できました。へき開では難しい特定箇所観察への応用が期待できます。
へき開断面と比較すると、従来のFIB加工断面ではGaビーム照射のダメージによりPN間のコントラスト差が弱くなります。そのため、断面SEM観察によるSiC基板の拡散層観察は、その目的に応じて以下の手法で切り分けています。
①エピ層(ドリフト層・バッファ層)やP層・N+層のできばえ確認:構造解析
⇒へき開による断面SEM観察で実施:任意箇所観察
②局所異常拡散の断面観察:不良解析
⇒FIB加工による断面SEM観察で実施:特定箇所観察
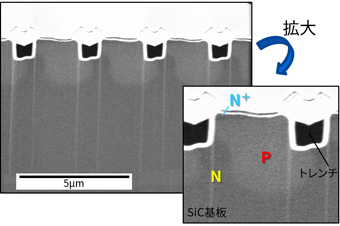
• PN間のコントラスト差をわずかに確認できる
• N+層はほとんど確認できない
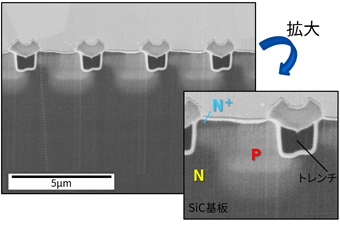
・PN間のコントラスト差を確認できる
・N+層が確認できる
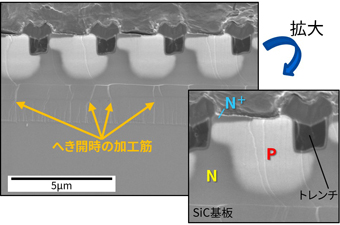
• PN間のコントラスト差を明瞭に確認できる
• N+層が明瞭に確認できる
へき開断面よりは劣るが、FIB断面よりもPN間コントラスト差が確認できます

へき開では不可能な、~サブμmオーダを狙った特定箇所の断面観察に有効です
FIB:Focused Ion Beam (集束イオンビーム)
SEM:Scanning Electron Microscope (走査電子顕微鏡)
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ