STEMと3DAPによるSiC MOSFET複合分析STEM and APT Analysis of SiC MOSFET
SiCデバイスの需要は近年高まっており、SiCデバイスを開発する上で結晶欠陥やドーパント元素分布の評価は重要です。今回STEM観察と3DAP分析を同一試料で実施することで、SiC MOSFET中の欠陥へのAl偏析を捉えることができました。その分析事例についてご紹介します。

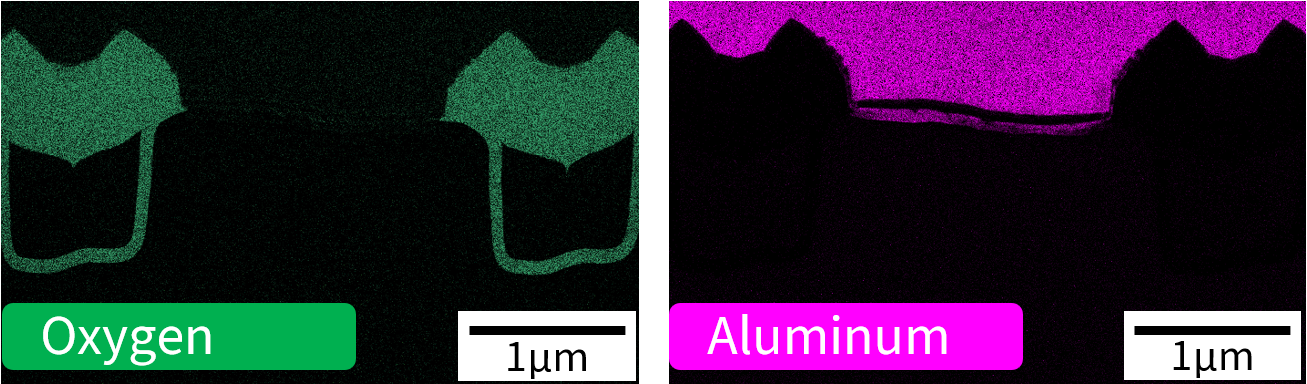
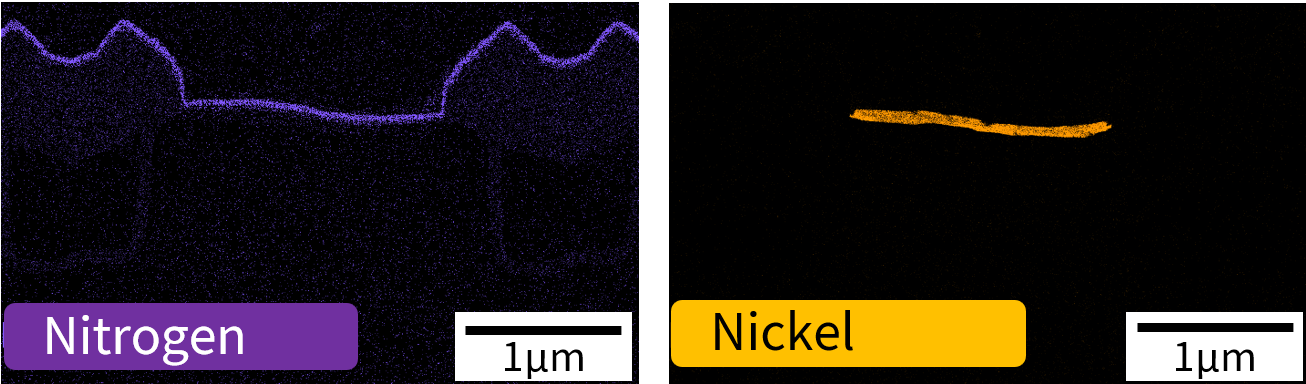
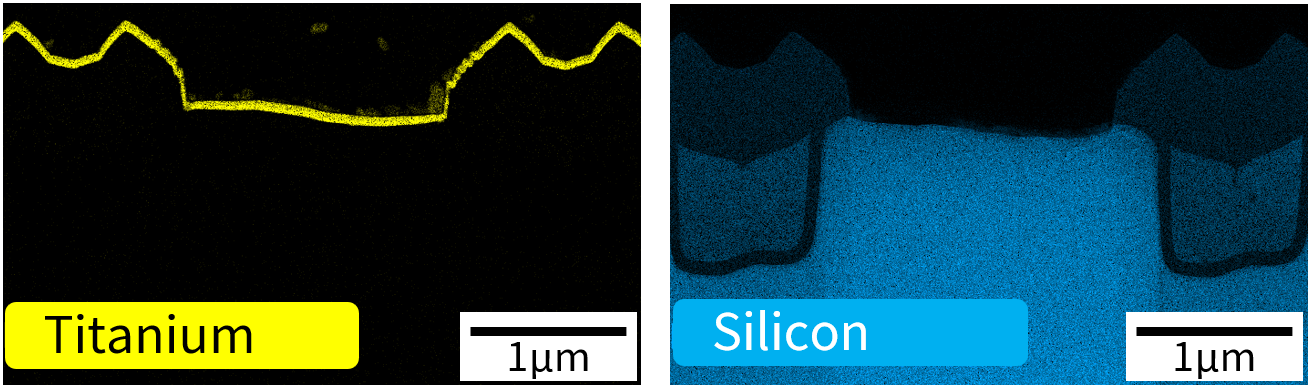
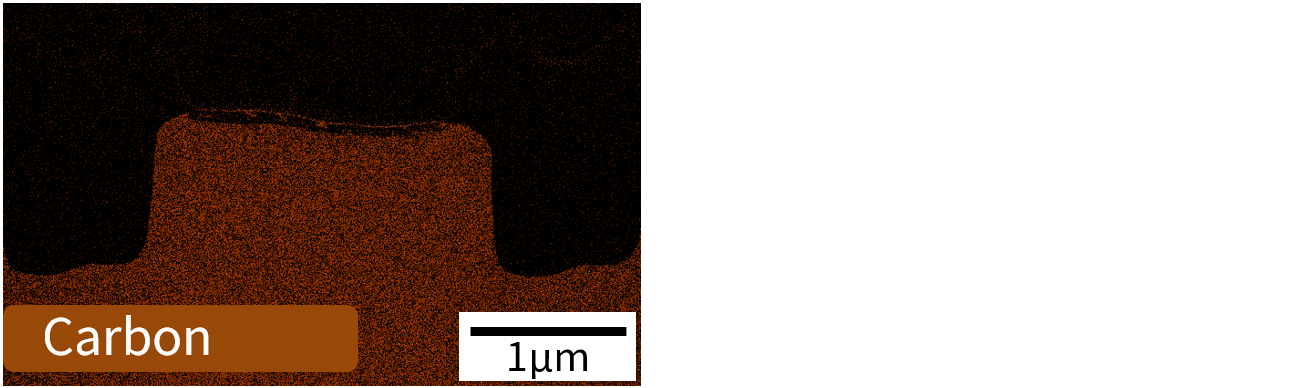
針状試料加工時にSTEM観察を併用することで、欠陥を複数含んだ針状試料を作製することができました。この試料を3DAP分析した結果、Alの不均一な分布が確認されました。STEM像の欠陥と3DAPデータのAl偏析の位置関係から、欠陥にAlが偏析していることがわかりました。
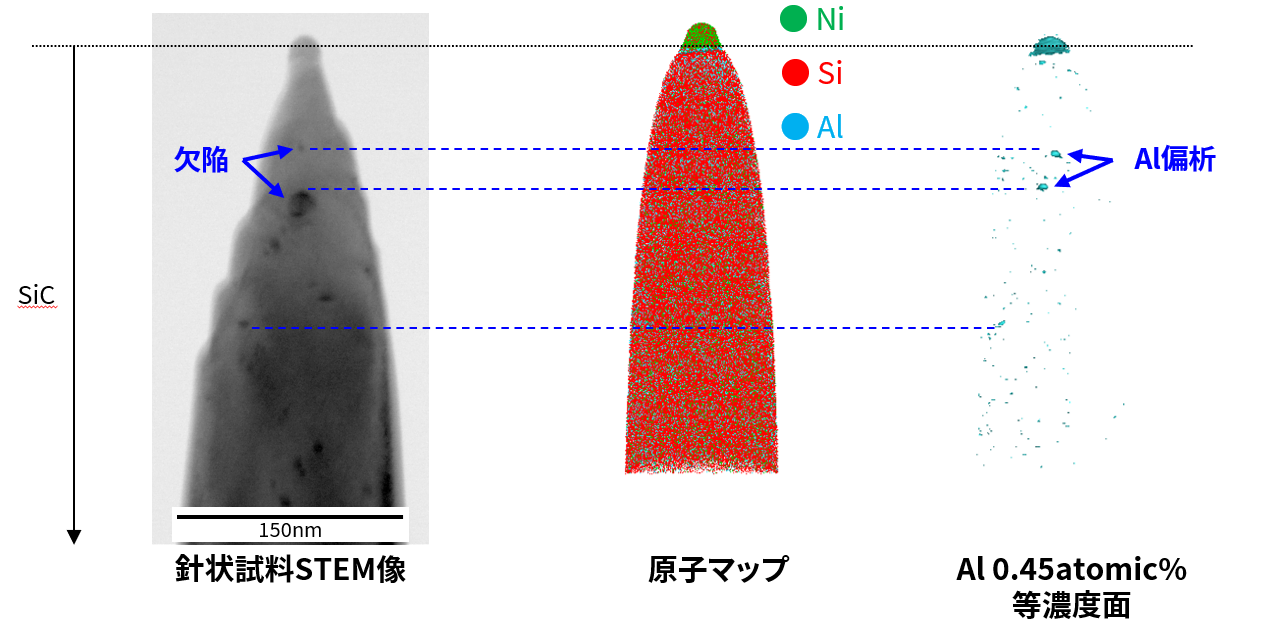
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ