TSV中メタルのEBSD測定EBSD Observation of Metal embedded in TSV
TSVは、Siを貫通するビアを形成しメタルを埋め込みます。このメタルの応力により酸化膜のクラックが発生し、リーク不良に至るケースがあります。EBSDで結晶粒ごとの結晶方位やグレインサイズを測定することにより、熱や応力による組織の変化、ひずみなどを観察でき、応力を評価することができます。
70度に傾けた試料に電子ビームを当てると、入射した電子ビームが試料内部で散乱します。散乱した電子は個々の結晶で回折し、この回折による電子線後方散乱パターン(EBSD Pattern)から結晶方位を解析します。

TSV : Through Silicon Via (Si貫通電極)
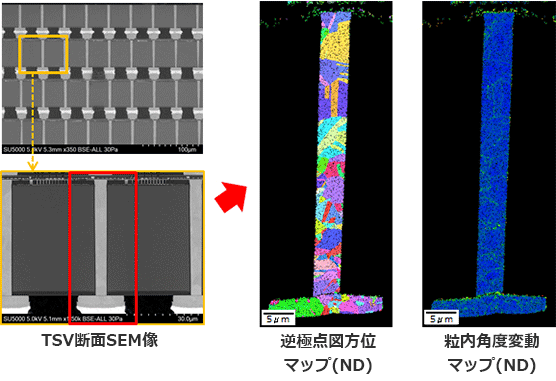
試料を70度に傾けて測定しているため、若干画像が斜めになっています。
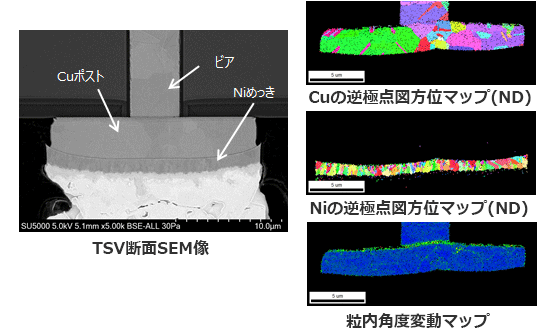
EBSDにより、ビアに埋め込まれたCuの配向性を明確に観察できます。
粒内角度変動マップの緑で表示された部分は結晶方位が粒内で緩やかに変化している箇所で、ひずみを示しており、ビアとCuポストの界面で集中してひずみが発生していることが分かります。チップを複数積層したことにより、応力が集中していることが推察できます。
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ