強制汚染ウェーハ提供サービスSi Wafer with Controlled Contamination Level
半導体製造工程における様々なプロセス評価を行うため、一定の濃度レベルに汚染したウェーハ(強制汚染ウェーハ)をご提供します。 目的に応じて、濃度・汚染方法・対象元素や領域(片面・両面)の選択が可能です。 また、全反射蛍光X線分析(TXRF)にてSiウェーハ上の金属分析を行う際に、標準ウェーハとしてご使用いただけます。
半導体製造工程における様々なプロセス評価を行うため、一定の濃度レベルに汚染したウェーハ(強制汚染ウェーハ)をご提供します。 目的に応じて、濃度・汚染方法・対象元素や領域(片面・両面)の選択が可能です。 また、全反射蛍光X線分析(TXRF)にてSiウェーハ上の金属分析を行う際に、標準ウェーハとしてご使用いただけます。

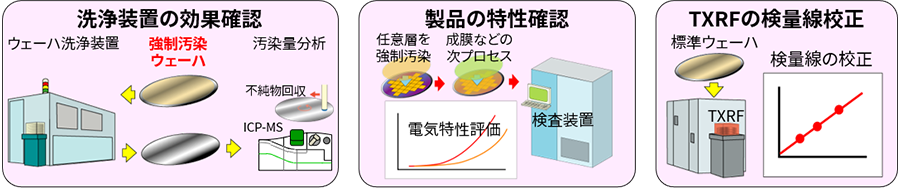
| ディップ法 | 噴霧法 | |
|---|---|---|
| 標準液汚染方法 | 浸漬、スピン乾燥 | 霧状噴霧塗布 |
| 汚染形態 | フィルム状 | 粒子状 |
| 対応ウェーハ | 100~ 300mm φ Bare-Siのみ |
~300mm φ パターン付も可 |
| 汚染領域 | 表裏全面 | 片面のみ1)、任意領域も可 |
| 汚染濃度範囲 | ×109~1014 2) | ×109~1015 2) |
1) 裏面への回り込み1%以下
2) 元素、ウェーハサイズにより応相談(単位:atoms/cm2)



300mmφウェーハの面内濃度分布を多点TXRF測定により確認しました。
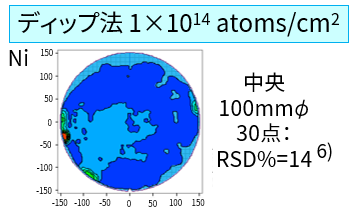
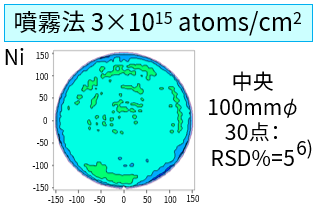
6) 面内分布均一性について、保証するものではありません。
[ 更新日:2025/04/24 ]
依頼に関するお問い合わせ