プロセス立上げ支援のための化学分析Chemical Analysis for Process Start-up Support
半導体プロセスにおいて各工程ごとの汚染量を把握し、コントロールすることは重要です。
実際のプロセス/ウェーハでの金属元素の熱拡散挙動の評価、材料や部品から発生するガスの評価、ウェーハ表面の有機物残渣・汚染量調査など、プロセス立上げ時に必要な分析評価についてご提供します。
半導体プロセスにおいて各工程ごとの汚染量を把握し、コントロールすることは重要です。
実際のプロセス/ウェーハでの金属元素の熱拡散挙動の評価、材料や部品から発生するガスの評価、ウェーハ表面の有機物残渣・汚染量調査など、プロセス立上げ時に必要な分析評価についてご提供します。

既存技術(ウェーハ金属汚染分析、ウェーハ強制汚染)と新たに導入したクリーンオーブンとの組み合わせにより、金属元素の熱拡散評価が可能です。
実際のプロセス/ウェーハでの金属元素の熱拡散挙動を推定することができます。
分析評価フロー
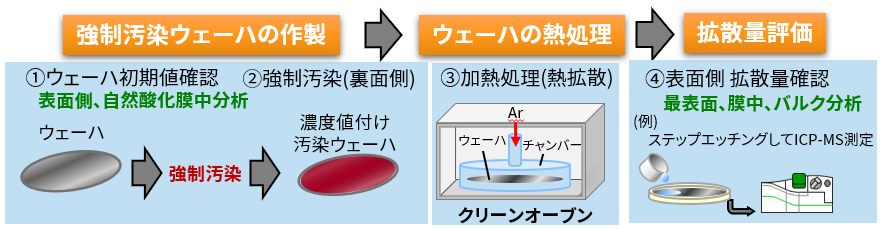
熱拡散量評価手法として、ICP-MS以外にSIMSによる深さ方向分布分析も可能です。
対応可能な膜種(膜厚:数nm~)
| 窒化膜 | TiN,TaN,SiN,AlN,NbN,WN,GaNなど |
| 酸化膜 | SrRuO,HfSiO,SrTiO,BaTiO,BPSG,BSG, PZT,SBTなど |
| 金属膜 酸化膜 |
CoPt,AlSi,MoSi,WSi,IrMn,GeSbTe, MnGe,MnGaなど |
BSG膜のB分析事例
| 繰り返し | B (%質量分率) |
| X1 | 4.41 |
| X2 | 4.43 |
| X3 | 4.44 |
| 平均 | 4.43 |
※単位はこの他、atoms/cm3での算出も可能です
材料や部品から発生するガスを把握することにより、表面付着物・工程改善策の確認や不具合発生原因の推定を行うことができます。昇温脱離ガス分析(TDS)では、真空中で試料を昇温加熱した際に、表面および内部から発生するガス種の同定(定性分析)やガス量の半定量分析ができます。
異なる2種類のSiN膜からの水素ガスの発生プロファイル、および発生量の違いをTDSで評価しました。膜組成の化学分析や結合状態の評価(FT-IR・XPSなど)と合わせて膜質を確認することができます。
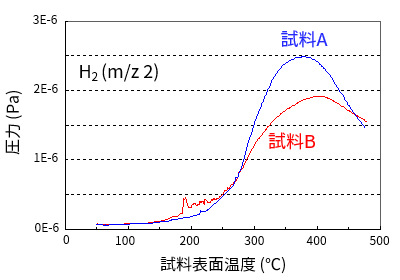
ウェーハ表面の微量の有機物を評価する方法としては、TOF-SIMSやXPSなどの表面分析、GC/MSやLC/MSなどのクロマト分析などがあります。表面分析手法と異なり、クロマト分析では、複数存在する有機成分を分離するため定性能力に優れており、また各成分を定量することも可能です。クロマト分析手法の1つであるSWA-GC/MSはウェーハ全面を加熱し、オンラインでGC/MS分析まで行うことで、コンタミネーションなく、高感度な分析が可能です。

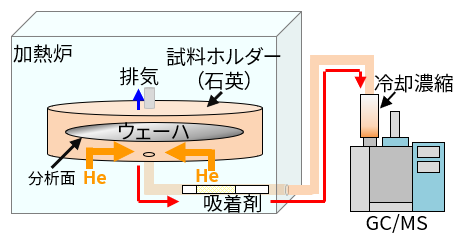
一般室に数時間放置したウェーハをSWA-GC/MSで分析した結果、壁材やその他の周辺部材から発生する添加剤(フタル酸エステル:DBP,DEHP、アジピン酸エステル:DOA、ハロゲン化リン酸エステル:TCEP)が多く存在していることが分かりました。
[ 更新日:2025/04/24 ]
依頼に関するお問い合わせ