3次元X線顕微鏡と高速FIBによる3次元解析3D Analysis by X-ray Microscope and FIB
3次元X線顕微鏡により、非破壊で不具合箇所の状態を観察し、同箇所について高速FIBを用いて解析することにより、3次元での詳細な形状と元素分布を観察することができます。
3次元X線顕微鏡により、非破壊で不具合箇所の状態を観察し、同箇所について高速FIBを用いて解析することにより、3次元での詳細な形状と元素分布を観察することができます。
電気特性測定や故障箇所特定装置を用いて不具合箇所を絞り込んだ後、3次元X線顕微鏡で不具合箇所の非破壊観察を行います。
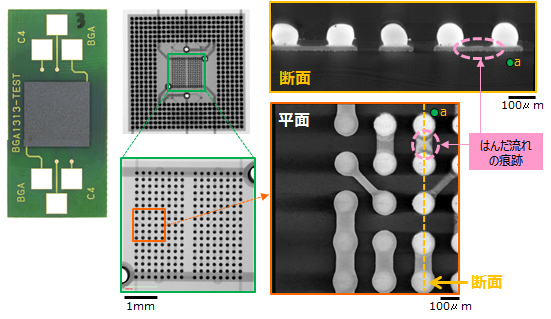

実装基板を研磨で除去して半導体パッケージを単体化し、非破壊観察で見つけた不具合箇所近傍まで断面研磨を行います。
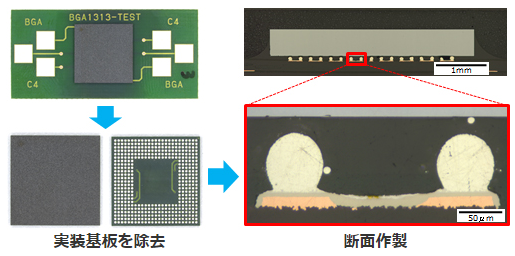
通常のFIBは幅・深さともに約20µm領域の加工が一般的です。それに対し、高速FIBではより広範囲の解析が可能です。
断面加工・観察・EDS分析を実施する箇所をピックアップします。
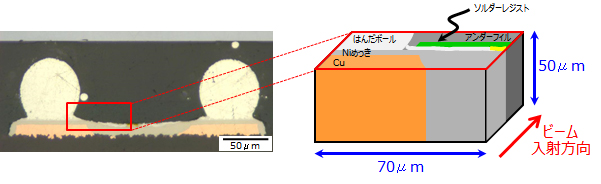
高速FIBで加工・SEM観察・EDSマッピングを繰り返し、3次元データを構築します。


約230枚のデータから3次元画像を構築

[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ