光電子分光による表面酸化膜の膜厚評価Thickness Estimation of Surface Oxide Layer by Photoelectron Spectroscopy
酸化膜の形成プロセスにおいて、酸化膜厚の制御は最も重要な項目の1つです。そこで、光電子分光を用いて表面酸化膜の膜厚を非破壊で見積りました。
表面が薄い酸化膜で覆われているような試料の場合、多くの元素の光電子ピークは酸化物成分と基板成分に対応して2つのピーク構造を示します。各成分のスペクトル強度を測定することによって酸化膜の膜厚を見積ることができます。
非破壊にて膜厚を求める分析手法はいくつかありますが、他の手法に比べ、特定箇所の膜厚の見積りが可能であるところが、この手法の特徴です。
Si 1sのピークはSi基板由来のピークとSiO2表面酸化膜由来のピークの2つから構成されています。それぞれの成分の積分強度Im, Ioを算出し、式(1)より酸化膜厚を見積りました。

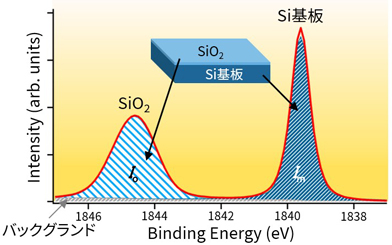
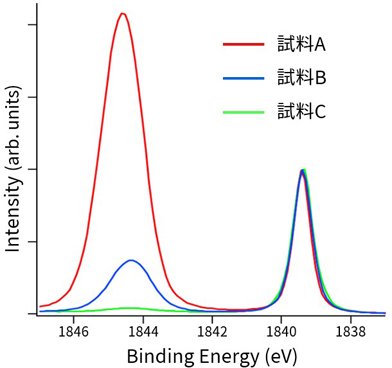


λ:非弾性平均自由行程(IMFP)については、IMFP の一般式である相対論を考慮したTPP-2M式1)から計算しました。
1) S. Tanuma et al., Surface and Interface Analysis 21, 165 (1994).
光電子分光から見積ったSiO2膜厚

Si基板上のSiO2表面酸化膜について、光電子分光から酸化膜厚を算出しました。
※膜厚によって使用装置が変わります。まずはご相談ください。
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ