FIB/SEM法による3次元構造観察3D Image by FIB / SEM Method
半導体デバイスの構造解析では、FIB/SEMで表面や断面を観察します。一般的には立体構造をした素子の一部分を切り出し、2次元の平板な画像を得ることで、どのような構造をしているかを推測します。3次元化すると、平板な画像ではなく立体的な画像を得ることができ、構造解析や故障箇所の特定、全体像の確認などに活用できます。
FIB/SEM装置内で、加工と断面観察を繰り返します。
繰り返し得られた断面像をつなぎ合わせて3次元化します。
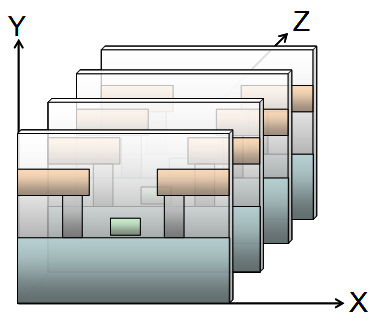
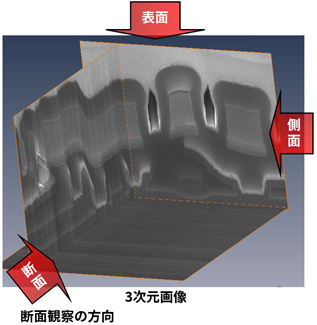
下記をクリックすると動画がご覧いただけます(MP4形式ファイル)
FIB: Focused Ion Beam (集束イオンビーム)
SEM: Scanning Electron Microscope (走査電子顕微鏡)
PEM(EMS): Photo Emission Microscope (エミッション顕微鏡)
OBIRCH: Optical Beam Induced Resistance Change (光ビーム加熱抵抗変動)
[ 更新日:2026/01/07 ]
依頼に関するお問い合わせ