半導体の表面形状評価手法Evaluation Methods of Surface Profile for Semiconductors
レーザ顕微鏡・触針式段差計・AFMは、それぞれ原理が異なる表面形状を測定する技術です。各手法の非接触・広視野、高精度接触測定の特徴を活用し、材料や用途に応じた最適な測定法をご提案します。
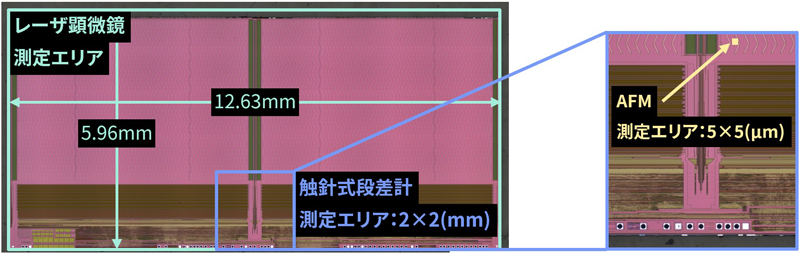
レーザ光を試料の一点に集光し、ピンホールで焦点外の光を除去することで高解像度・高コントラストの画像を二次元(2D)、三次元(3D)で取得します。三次元構造の解析が可能で、微細構造の観察に優れています。
評価例
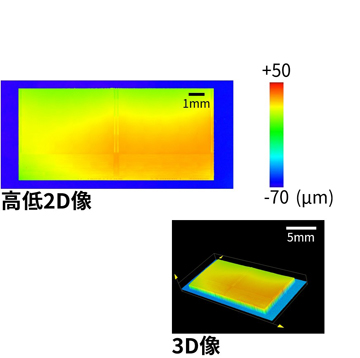
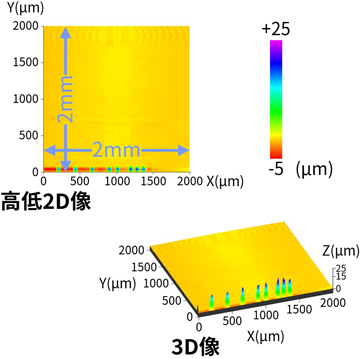
探針で表面を走査し、変位量から表面形状を画像化します。
評価例
カンチレバー(てこ)の先端に取り付けられた微小探針で表面を走査し、カンチレバーのたわみを反射光変化として検出、表面形状を画像化します。
評価例
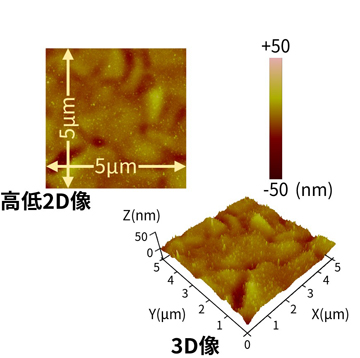
| 比較項目 | レーザ顕微鏡 | 触針式段差計 | AFM |
|---|---|---|---|
| 測定範囲 | 128μm×128μm~ 数cm×数cm *スティッチング |
数百μm×数百μm~ 200mm×200mm |
1μm×1μm~ 80μm×80μm |
| 最大高低差 | 6.5mm | 327μm | 2μm |
| 分解能 (垂直方向) |
0.12μm (表示分解能:0.5nm) |
0.078nm | 0.01nm |
| 分解能 (水平方向) |
0.2μm (表示分解能:1nm) |
探針 曲率半径2μm |
微小探針 曲率半径2nm |
| ステージサイズ | φ100mm | φ200mm | φ200mm |
| 特徴 | 非接触でダメージなし | 試料反射率の影響なし | 高空間分解能測定 |
| 制約 | レーザが透過する 素材は測定不可 |
接触方式につき 柔材は測定不可 |
局所観察に限る |
*スティッチング:複数の画像をつなぎ合わせて、1つの広い視野の画像にする機能
3手法ともに、希望箇所のラインプロファイルや各種ラフネス値(Sa,RMSなど)をご提供可能です。
試料形状や目的に応じて最適な手法をご提案します。
[ 更新日:2026/03/03 ]
依頼に関するお問い合わせ