放射光トポグラフィーによる欠陥評価Defect Analysis by Synchrotron X-Ray Topography
SiCやGaNといった化合物半導体においては、結晶欠陥が多く含まれており、素子特性に大きな影響を与えます。放射光を用いたトポグラフィー評価により、高い分解能で4インチ~6インチの大口径ウェーハ全面の欠陥評価を非破壊で行うことが可能です。
単結晶基板にX線を照射すると、ブラッグの条件を満たす角度で回折が起こります。
このとき、転位や積層欠陥による格子ひずみにより、局所的に回折条件が変動し、欠陥周辺の回折強度が変化します。
この強度変化をX線フィルムや原子核乾板で像として得ることにより、欠陥の種類、分布を評価することが可能となります。
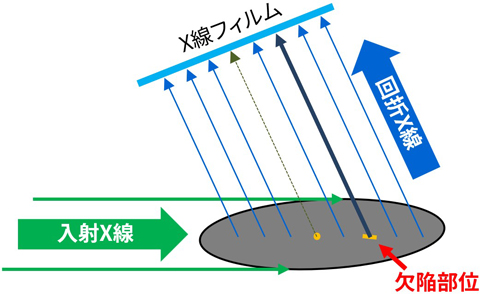
局所的な欠陥部位では、動力学的回折により、回折X線強度が母材領域に比べて増強・減弱し、コントラスト差として像が得られます。
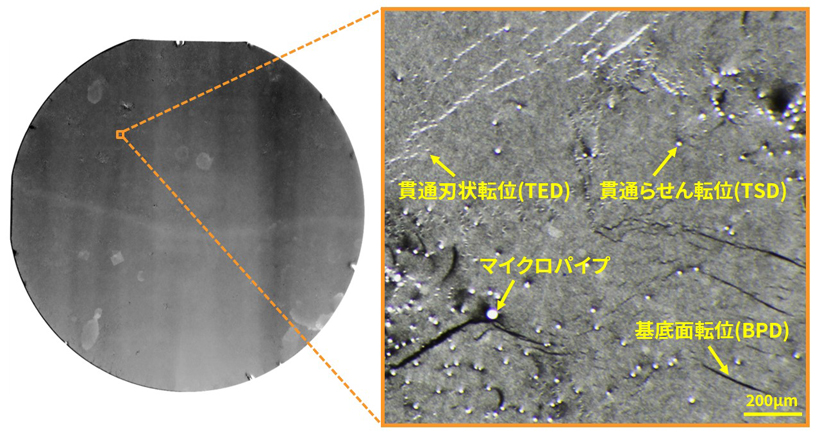
・各種の結晶欠陥を数μmの解像度で可視化することが可能です。
・ラボ装置では検出できない、貫通刃状転位(TED)の検出が可能です。
※トポグラフィー測定は、外部放射光施設を利用するため、利用手続きから測定までにある程度の時間をいただきます。
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ