AFMによる微小表面粗さ測定Measurement of the Nanoscale Roughness by Atomic Force Microscopy
原子間力顕微鏡(AFM : Atomic Force Microscope)はナノスケールの微小な表面形状を3次元で可視化・数値化できる手法です。
AFMは、走査型プローブ顕微鏡(SPM : Scanning Probe Microscope)の一種であり、試料と触針の間の原子間力を利用し、ナノレベルの凹凸の情報が得られます。
AFMにはいくつかの測定手法がありますが、測定試料を破壊する懸念が少ないタッピングモードが一般的です。
タッピングモードでは、カンチレバーを振動させながら試料に近づけます。試料を軽く叩く(タッピングする)イメージです。探針が試料表面に接触すると、カンチレバーが振動する振幅に変化が見られます。この変化を光センサで検知し、変化がほとんどゼロとなるようにカンチレバーを上下させます。カンチレバーの位置を記録して、試料表面の形状を3次元画像として構築します。
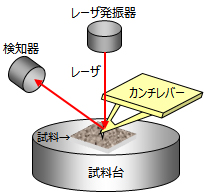
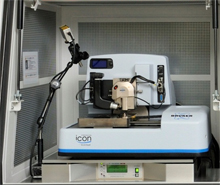
PEFC触媒層の表面粗さ
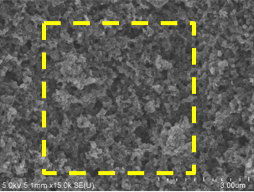

| 比較項目 | AFM | 触針式 段差計 |
共焦点 顕微鏡 |
SEM | |
|---|---|---|---|---|---|
| 特徴 | ノイズレベル 0.03nm↓ |
ライン スキャン |
測定範囲が 広い |
画像のみ | |
| 測定可能 範囲1) |
最大視野 | 80µm ×80µm |
200mm ×200mm |
1,420µm ×1,140µm |
- |
| 最大高低差 | 2µm | 327µm | 15mm | - | |
| 垂直分解能 | 0.01nm | 0.078nm | 10nm | - | |
| 材料 制限 |
絶縁材料 | ○ | ○ | ○ | ×3) |
| 透明材料 | ○ | ○ | × | ○ | |
| 光沢材料 | ○ | ○ | × | ○ | |
| 材料ダメージ | ○ | △ | ○ | △ | |
| やわからい 材料 |
○ | × | ○ | △ | |
| 帯電しやすい 試料 |
○ | ○ | ○ | × | |
| 用途 | 3次元表示 | ◎ | × | ○ | × |
| 粗さ測定2) | Ra・Rz・Rq ほか |
Ra・Rz・Rq ほか |
Ra・Rz・Rq ほか |
× | |
1) 当社所有の装置の仕様での提供範囲およびパラメータ(JIS B0601:2001)
2) Ra : 算術平均粗さ、Rz : 最大高低差、Rq : 二乗平均平方根粗さ
3) 導通のためのスパッタ処理が必要
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ