高温XRDによる極薄膜の結晶性評価Crystalline Evaluation of the Ultra thin Film by High Temperature XRD
高温でのX線回折(XRD)は、各種材料の温度条件による相変化・化学反応・格子定数の変化を知るために有効な手段です。
nmオーダの極薄膜の結晶構造の変化をIn-Plane XRD法+高温測定で評価した事例をご紹介します。
XRD: X-ray Diffraction (X線回折)
In-Plane XRD法とは、極低角でX線を入射して、面内方向に検出器を走査させる方法です。入射X線は表面から深くまで入らず、かつ表面に対して垂直な回折面のみを検出することができます。
この測定法を用いることで数nmの極薄膜についても、結晶の情報を得ることができます。
ドーム状カバーの高温ユニットを用いることで、In-Plane XRD法などの極低角入射が必要な測定もできます。
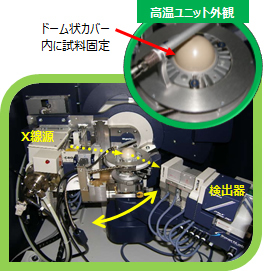
※Out of Plane XRD測定(表面に平行な回折面の測定)により、バルク材の高温XRD測定も可能です。
大気条件下において、室温・300℃・450℃の各温度で、HfOx薄膜(10nm)のIn-Plane XRD測定を行いました。室温と300℃では、HfO2の回折線を確認できませんが、450℃では回折線を確認できました。
この結果から、本試料のHfOxは結晶化の温度が300~450℃の間であることがうかがえます。
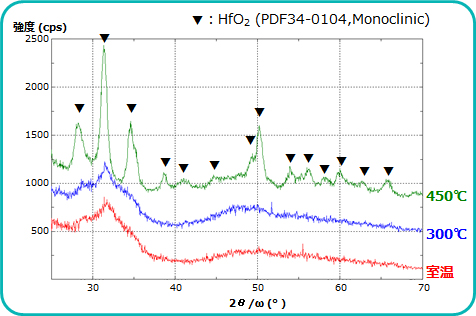
YouTubeサイト : 薄膜X線回折(XRD)の説明動画
[ 更新日:2025/04/24 ]
依頼に関するお問い合わせ