X線反射率測定(XRR)による薄膜評価Thin-Film Parameters Analysis using X-Ray Reflectivity
X線反射率測定(XRR)は、臨界全反射角近傍でのX線の減衰や干渉縞のあるX線のプロファイルと計算で得られたプロファイルをフィッティングさせることで表面(界面)粗さ・膜密度・膜厚の情報を得ることができます。
X線が極低角で入射する場合、屈折率は1よりもわずかに小さく(θ0>θ)、臨界全反射角以下では屈折の効果が大きくなり全反射が生じます。
全反射条件近傍の測定で、X線反射率(入射X線強度に対する鏡面反射X線強度)を測定し、薄膜モデルから計算されたX線プロファイルとフィッティングさせることで、以下の情報を求めることができます。
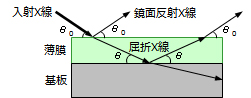
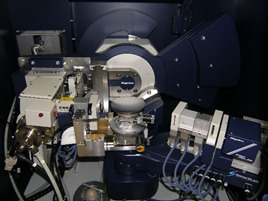
入射角が、臨界全反射角(X線が全反射する角度)を超えると、X線は屈折を伴い試料内に入りこむため、入射角度の増加に伴い急激に反射X線強度が減少します。 (平滑な表面では入射角度の-4乗に比例)
表面粗さが大きくなるほど、反射X線強度の減衰が著しくなります。(下図、緑点線で表示)
界面粗さが大きくなると、高角度側の振幅の減衰が著しくなります。
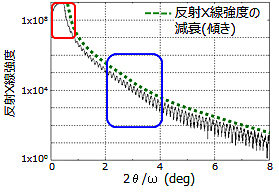
※赤枠・青枠内の説明は下記参照
膜密度は全反射角および振幅から算出します。
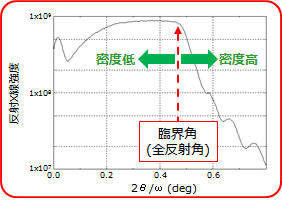
膜厚により干渉の周期が変動します。
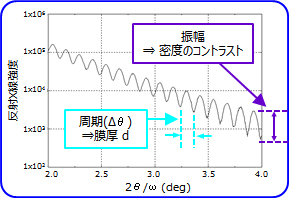
狙い膜厚さ15nmのSi3N4膜(Si基板上)の測定プロファイルに対し、シミュレーションにより、表面(界面)粗さ・膜密度・膜厚を算出した事例をご紹介します。
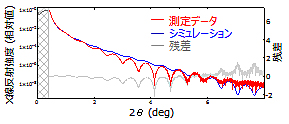
| 層 | 膜種 | 膜厚 (nm) |
膜密度 (g/cm3) |
粗さ (nm) |
| 1 | Si3N4 | 15.0 | 2.44 | 0.5 |
| 基板 | Si | - | (2.33) | 0.0 |
狙いのSi3N4単層と仮定し解析した結果、測定データとシミュレーションの振幅が大きく異なります。(残差大)
Si3N4層およびSi基板と密度の異なる層が存在する可能性がうかがえます。

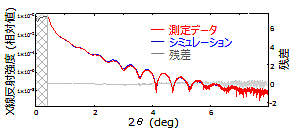
| 層 | 膜種 | 膜厚 (nm) |
膜密度 (g/cm3) |
粗さ (nm) |
| 2 | Si3N4 | 15.1 | 2.44 | 0.5 |
| 1 | SiO2 | 1.0 | 2.16 | 0.0 |
| 基板 | Si | - | (2.33) | 0.0 |
界面層としてSiO2層を仮定し解析した結果、測定データとシミュレーションはよく一致することから界面層の存在を示唆する結果が得られます。このように、埋もれた界面が存在しても解析が可能です。
[ 更新日:2025/04/24 ]
依頼に関するお問い合わせ