パワーMOSFETの故障解析Failure Analysis of Power MOSFET
パワーMOSFETの故障解析には、不具合特性を維持しながら故障箇所を特定することが重要です。そのために、裏面からOBIRCH/PEM(EMS)で特定し、裏面から物理解析を行います。
目的 : お客様の実装工程で不具合が発生した。実装工程の問題なのか、購入した半導体の問題なのか切り分けたい。
製品 : XX社製 MOSFET 製品名 XXXXXX
故障履歴 : 実装前には半導体の動作を確認していない。実装後に不具合が明らかになった 。
不良モード : ゲート - ソース間ショート
調査ポイント
試料に加わったストレス(電圧・温度・湿度・イニシャル)と電気特性が、故障メカニズムの推定に重要です。
パワーMOSFETは、チップ表面は金属電極で覆われていることと、表面側のモールド樹脂を除去すると特性が変化する可能性が高いことから、通常、裏面から観察します。
さらに、Si基板にドープされた不純物濃度が高く、赤外光が透過しにくいのでSi基板を薄く研磨します。
チップの加工により電気特性が変化する可能性が高いので、電気特性に変化がないことを確認することが重要です。

OBIRCH観察
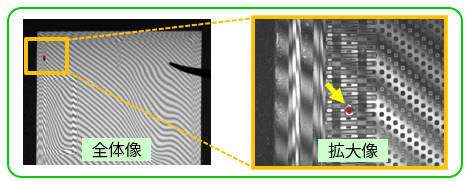
PEM(EMS)観察

発光は検出されなかった
裏面からOBIRCHで観察し、外周のゲート配線上に信号を確認。電気特性とOBIRCH信号箇所から、不具合はEOS破壊と推測。
OBIRCH : Optical Beam Induced Resistance Change (光学ビーム誘導抵抗性変化)
PEM(EMS) : Photo Emission Microscope (エミッション顕微鏡)
EOS : Electrical Overstress
ポイント
これまでに経験した知見を基に不具合モードを推測します。

赤外線カメラで裏面から表面パターンを確認し、OBIRCH信号箇所まで断面研磨を実施。
参考
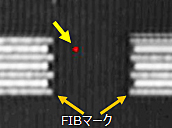
裏面から表面の配線パターンが観察できない場合や、繰り返しパターンの場合は、FIBでマーキングしてから、試料作製を行う。
FIB : Focused Ion Beam (集束イオンビーム)
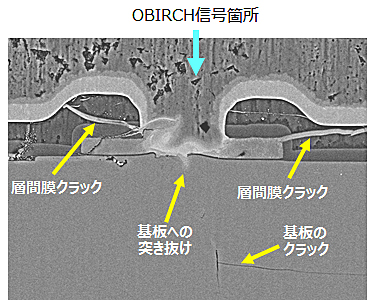
OBIRCH信号箇所を断面から観察し、ゲート酸化膜破壊を確認した。
不具合はEOSによるもので、ダメージが大きく、層間膜のクラック、ゲート電極の溶融、基板への突き抜け、基板のクラックが発生している。
SEM : Scanning Electron Microscope (走査電子顕微鏡)
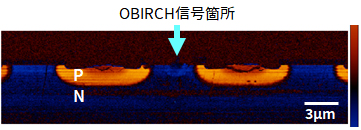
SCMで、拡散層は正常に形成されており、不具合はプロセス起因ではないことを確認。
クラックはEOS破壊によるもの。
SCM : Scanning Capacitance Microscope (走査型静電容量顕微鏡)
赤外光で裏面から表面パターンを確認しながら、OBIRCH信号箇所まで断面研磨を行なった結果、ゲート酸化膜破壊・基板クラック・層間膜クラックを確認しました。
破壊形状から、不具合はEOS起因と推測します。
貫通電流によってジュール発熱し、局所的に融点を超えるほど温度が上昇して破壊したと考えられます。

[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ