OBIRCH/PEM(EMS)による故障箇所特定Fault Localization by OBIRCH / PEM (EMS)
半導体デバイスやFPDの故障解析では、故障発生状況の把握、外観観察および電気特性取得の後、故障メカニズムの推測を行います。次に故障箇所の特定を行い、表面または断面から観察や分析を行うことで、故障メカニズム解明の一助とすることができます。特に故障箇所の特定は重要であり、光ビーム加熱抵抗変動(OBIRCH)やエミッション顕微鏡〔PEM(EMS)〕を活用しています。
半導体デバイスやFPDの故障解析では、故障発生状況の把握、外観観察および電気特性取得の後、故障メカニズムの推測を行います。次に故障箇所の特定を行い、表面または断面から観察や分析を行うことで、故障メカニズム解明の一助とすることができます。特に故障箇所の特定は重要であり、光ビーム加熱抵抗変動(OBIRCH)やエミッション顕微鏡〔PEM(EMS)〕を活用しています。
OBIRCHは、レーザを2次元走査し、照射箇所の電流変動を可視化することで故障箇所を特定します。デバイスに定電圧を印加した状態で、電流が流れている経路上に赤外レーザを照射します。すると、レーザによって局所的に温度上昇が生じ、温度上昇に応じて抵抗が変化します。その結果は電流の変化として検出されます。
電流経路にボイドや欠陥などの異常があると、その部分の温度上昇・抵抗の温度係数は正常な箇所と異なるため、正常な箇所とは異なる電流変動として検出されます。
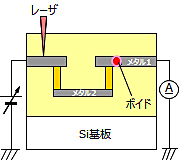
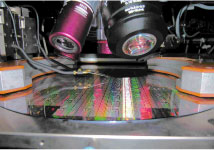
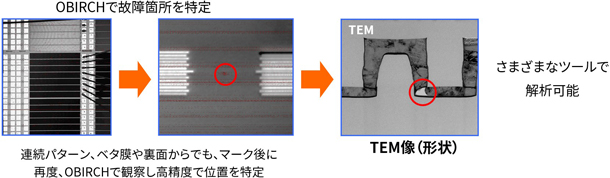
OBIRCH: Optical Beam Induced Resistance Change (光ビーム加熱抵抗変動)
PEM(EMS): Photo Emission Microscope (エミッション顕微鏡)
TEM: Transmission Electron Microscope (透過電子顕微鏡)
[ 更新日:2026/01/13 ]
依頼に関するお問い合わせ