GaNゲート酸化膜の不純物分析Impurity Analysis of Gate Oxide Film on GaN by SIMS
GaNデバイスにおいて、ゲート酸化膜への前工程由来成分(不純物)の拡散は、絶縁性不良の原因につながるため、その濃度分布や拡散源の特定が必要となります。今回当社では、薄膜加工したGaN化合物の表面に高い平坦性をもたせる技術を開発しました。それによりSIMSを用いてゲート酸化膜上層側からの不純物拡散を捉えることに成功しました。
アプローチ
ゲート絶縁膜にドライエッチングなど外部成分が侵入するケースでは、その分布形状はGaN層に向かって減衰勾配となります。SIMSでは測定方向から見て上昇勾配に対して高いプロファイル急峻性が得られるため、GaN層側からの測定により高精度なプロファイルを求めることができます。この際、前処理として着目層(ゲート酸化膜)近傍まで薄膜化する研磨が一般的に利用され、仕上がりの平坦性や研磨厚制御が分析精度を左右します。
SIMS:二次イオン質量分析法 (Secondary Ion Mass Spectrometry)
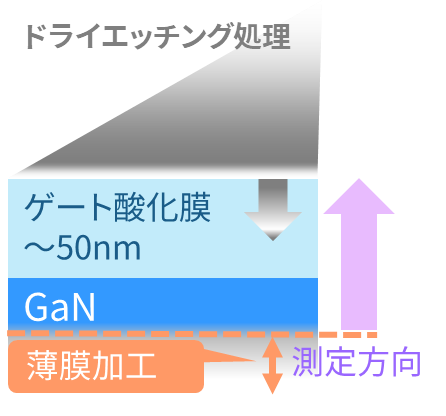
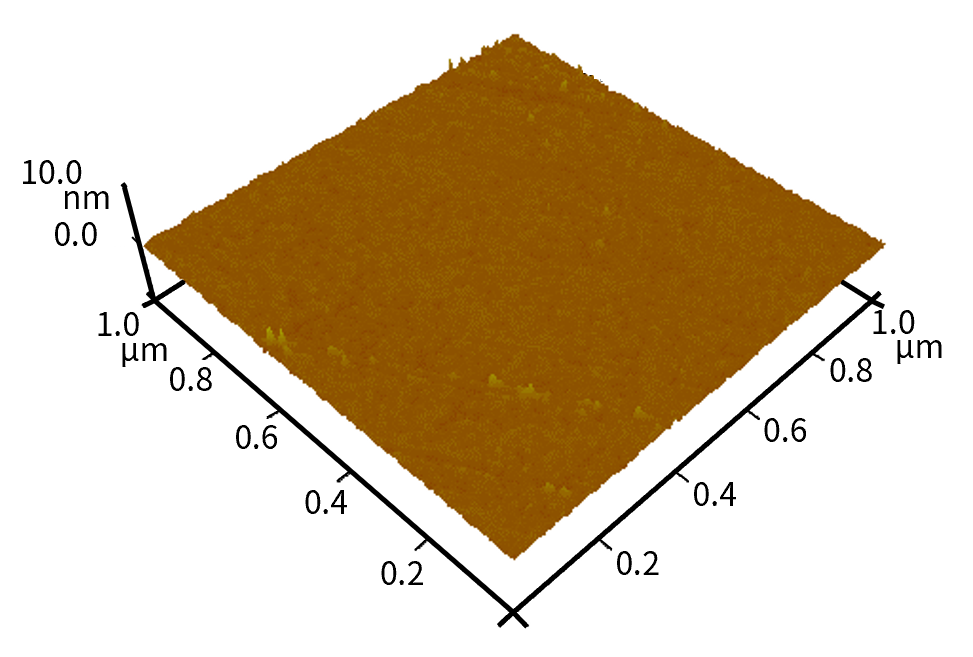
高精度研磨加工
左図は薄膜化したGaN加工面のAFM像です。化合物に特化した薄膜加工技術を適用することで、以下の仕様を実現します。
AFM:原子間力顕微鏡 (Atomic Force Microscope)
分析事例
GaN上に酸化膜を成膜し、ドライエッチング処理(CF4)した試料に対して、GaN層を薄膜化し測定した事例を右に示します。不純物としてH,C,Fをモニターし、結果としてFにドライエッチング成分由来と推定される勾配が認められました。SIMS特有のノックオン効果の影響を抑制し、より実際に近い拡散勾配を捉えることが可能となりました。

[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ