TOF-SIMS分析の微小・凹凸表面への応用Application for Submicron and Uneven Surface by TOF-SIMS
TOF-SIMSは最表面を高感度に測定ができる表面分析方法として知られていますが、先端デバイスや先端材料の評価に対し多くの課題があります。当社独自の分析手法により、微小領域・凹凸形状試料および表面が汚染されている試料に対して改善した事例をご紹介します。
一般的なTOF-SIMS分析(定性モード)では、1μmφ以下の成分の二次イオン像は得られませんが、当社独自の分析手法により、約0.5μmφの成分の場所特定および、その成分を同定可能な二次イオンスペクトル〔酸化防止剤(イルガノックス)〕が得られました。
また、高い質量分解能の実現により、成分の同定能力が大幅に向上しました。
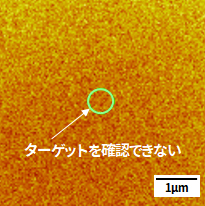
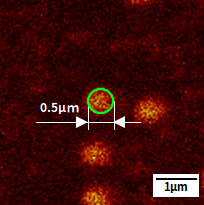


これまで、表面に凹凸のある試料の分析は困難でしたが、当社が新規導入した装置では特殊な測定モードを用いることで優れたイオン像が得られます。
また、有機物へのダメージが少ないArガスクラスターイオンビームによるスパッタを併用することで、最表面の成分を除去し、下地の評価も可能になりました。
総イオン像
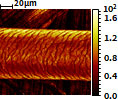
ヘアケア剤由来
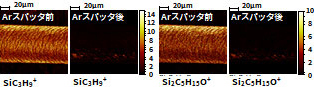
生体由来成分
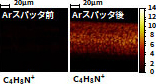
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ