FIBによる裏面加工法Back Side Processing Method using Focused Ion Beam
FIBにより半導体デバイス試料を表面側から加工した場合、内部構造材料のイオンミリングレート差により加工面に凹凸が発生し、特に硬い材料の直下は試料膜厚が厚くなるなど、TEM観察に悪影響を与えてしまいます。
コンタクトボトムなどの微細な異常を観察する際は、裏面のSi基板側から加工することで上層の硬い構造による加工の影響を受けることなく観察できます。
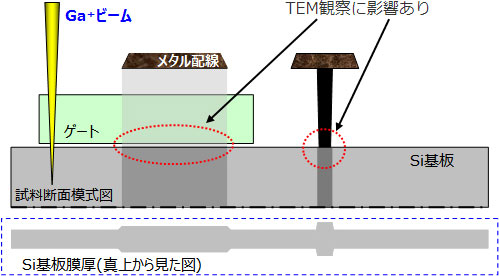
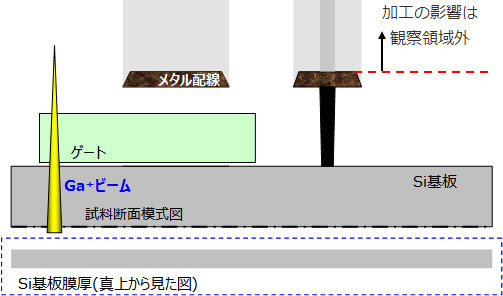
表面からの加工(通常)は、上部配線・コンタクト・ゲート上部の構造物が平坦な加工を阻害し、Si基板直上の構造把握に悪影響を及ぼしています。
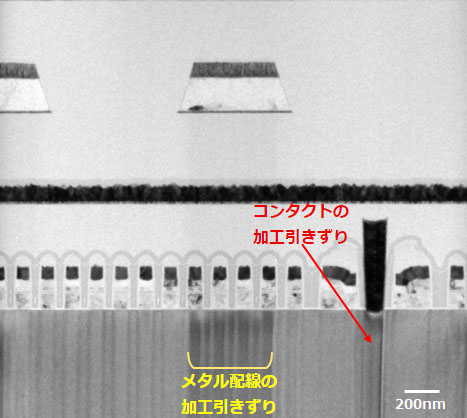
裏面からの加工では、重要なSi基板直上の部位が均一に加工できています。
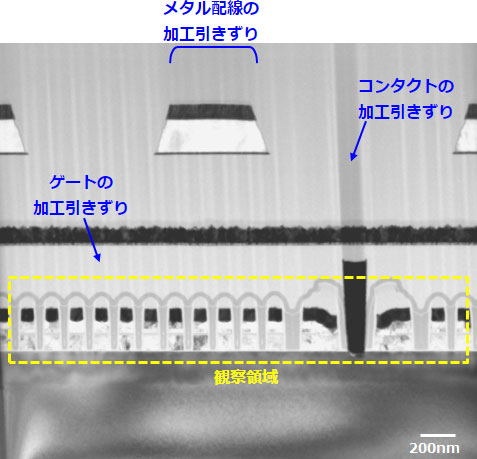
[ 更新日:2025/11/19 ]
依頼に関するお問い合わせ