薄膜X線回折(XRD)X-ray Diffraction (XRD) for Thin-Film
薄膜X線回折は、数nmレベルの薄膜の結晶構造同定に加え、X線反射率測定による多層膜の膜密度・膜厚・粗さの解析も可能です。
薄膜X線回折は、数nmレベルの薄膜の結晶構造同定に加え、X線反射率測定による多層膜の膜密度・膜厚・粗さの解析も可能です。
薄膜X線回折では、平行性の良いX線を試料に極浅い角度で入射させることで、X線の侵入深さを極めて浅くすることができ、In-Plane XRDによる薄膜の結晶性評価や、XRRによる薄膜の物性測定ができます。
XRR: X-ray Reflectivity (X線反射率測定)
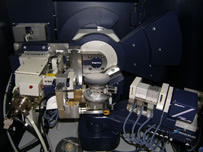
試料表面に対して全反射条件となるX線入射角近傍で面内方向に2θχ/φ走査することで、数nmの極薄膜でも高感度で回折線を検出します。
(試料表面に垂直な結晶面からの検出)
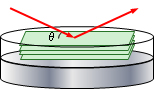
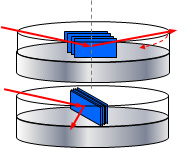

X線を極低角で入射する場合、屈折率は1よりもわずかに小さい(θ0>θ)ため、屈折の効果が大きくなり全反射が生じます。全反射条件近傍の測定で、X線反射率を求めることができます。
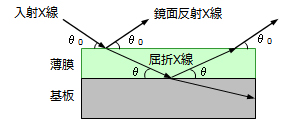
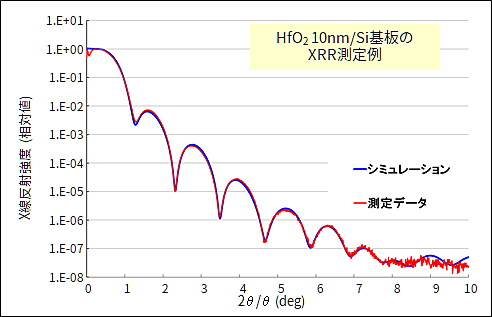
YouTubeサイト : 薄膜X線回折(XRD)の説明動画
[ 更新日:2025/04/24 ]
依頼に関するお問い合わせ