飛行時間型二次イオン質量分析 (TOF-SIMS)Time of Flight Secondary Ion Mass Spectrometry
飛行時間型二次イオン質量分析(TOF-SIMS)は、極表面に存在する無機・有機成分を分子レベルで高感度に評価できる手法で、マッピング分析や深さ方向分析が可能です。
高真空中でパルス化した一次イオンを試料に照射すると、試料の極表面がイオン化され、単原子だけでなく有機物などの質量数の大きい分子が二次イオンとして放出されます。飛行時間型質量検出器で二次イオンを高い透過率・収率で分離し、得られた精密質量数から極表層の分子構造情報を高感度で評価します。
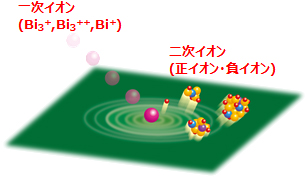

【各種試料に対応】
大型チャンバーや専用ホルダーを使用して非破壊で200mmウェーハやフォトマスクの測定が可能


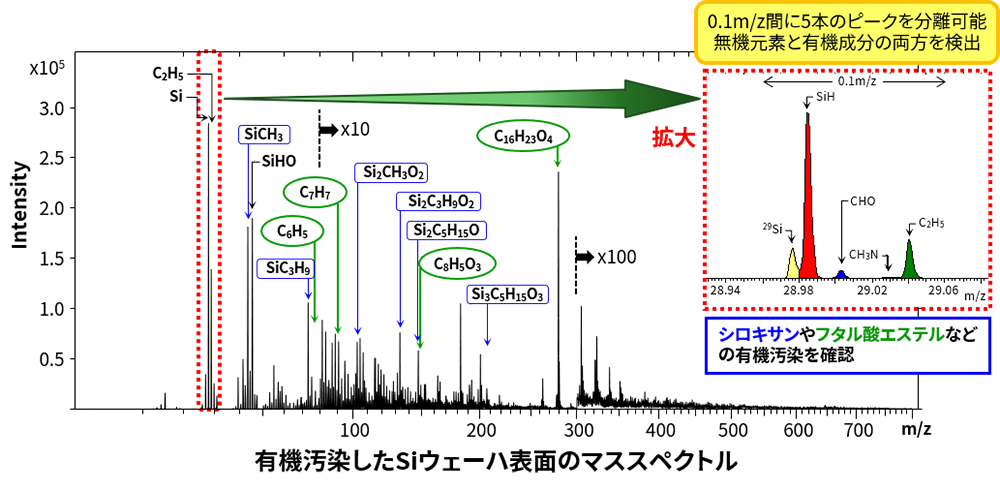
シロキサンやフタル酸エステルなどの有機汚染を確認
人体由来の無機成分・有機成分を検出





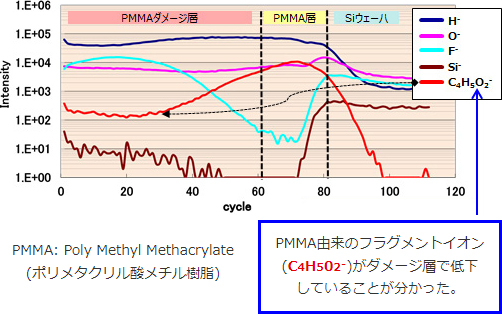
フラグメント化を抑えて、大きな分子量の有機物の分布を分析できます。

桁違いの高濃度成分だけを減衰させることで検出器を飽和させずに、微量成分とともに正確なプロファイルを取得できます。
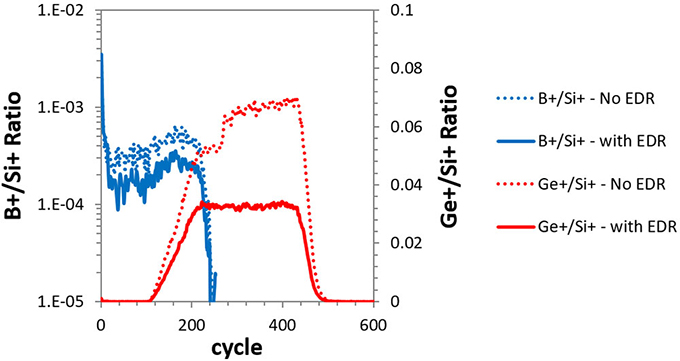
任意成分での3次元イメージングが可能で、異常成分の同定と分布の確認ができます。
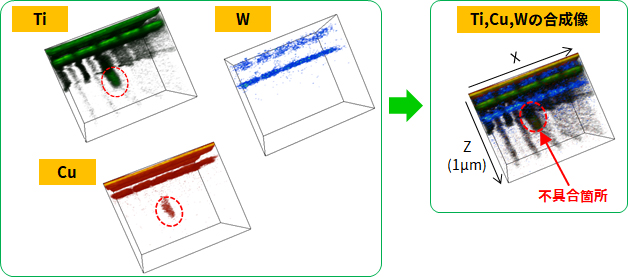
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ