二次イオン質量分析(SIMS)Secondary Ion Mass Spectrometry
二次イオン質量分析(SIMS)は、ppbレベルの極微量元素を同定・定量できる非常に高感度な分析手法です。スパッタしながら測定することで、膜中の微量成分の深さ方向分布を得ることができます。
真空中で固体表面にCs+やO2+などの一次イオンを連続照射すると、試料表面から原子(中性・イオン)が弾き出されます(スパッタリング現象)。試料から放出されたイオンの質量を分析することにより、元素の種類とその濃度を明らかにします。質量分析では、イオン種同士の干渉を除き、検出を妨害する要素が限定されるため、非常に高感度な分析が可能です。イオン照射により試料が次第に削れていくため、連続的にデータを取得することにより深さ方向分析ができます。一次イオン種(O2+・Cs+)は分析の目的に応じて使い分けます。
一次イオンO2+により元素を正イオン化(M+)、一次イオンCs+により負イオン化(M-)を促進させる傾向にあります。この特徴から、金属など正のイオン化率が高い元素は一次イオンO2+、ハロゲンなど負のイオン化率が高い元素はCs+を用いて測定することで高感度化します。
希ガスなど正・負のどちらのイオンにもなりにくい元素に対しては、Cs+を用いてCsM+分子イオンで取得することができます。

分析モードとして一次イオンO2+によるM+モード、Cs+によるM-モード、CsM+モードの3種類から選択します。各分析モードの特徴は以下のとおりです。
M+モード (一次イオンO2+)
一価に正イオン化した対象元素を検出するモードです。主に金属系元素を高感度で検出することができます。一方、水素・酸素などの大気成分やハロゲン系元素に対する検出効率は低い傾向にあります。また、測定開始からある深さを超えると測定面に凹凸が発生するため、深さ方向分解能を維持した測定距離に制限が生じます。
M-モード (一次イオンCs+)
一価に負イオン化した対象元素を検出するモードです。水素・酸素などの大気成分やハロゲン系元素を高感度で検出することができます。一方、金属系元素に対する検出効率は低く、半導体デバイスを対象とした分析において、これらは金属膜積層の層位置関係を把握するモニタ元素(定量は不可)として使用することが一般的です。
CsM+モード (一次イオンCs+)
一次イオンCs+(~100%正イオン)と対象元素の中性原子で構成される一価の分子イオンを検出するモードです。主に希ガスを測定するモードであり、イオン化傾向によらず全ての元素を測定することができ、また原理上、SIMS特有の材料間感度変化(マトリックス効果)が小さいという特徴をもちます。一方、収量面においてはM+やM-モードと比較して、一桁もしくは元素によってはそれ以上に低い傾向があります。

| 検出情報 | 元素深さ方向分布 (H~U) |
| 検出感度 | ppb~※ |
| 検出領域 | 10~数百μmΦ |
| 深さ方向分解能 | 1nm~(step) |
※元素・母材・分析モードにより異なります
Si基板上にFSG膜(Fを添加したSi酸化膜)、その上にSiO2膜を三段階で成膜した構造について、FSGからSiO2膜へのFの拡散プロファイルを調査しました。その結果より次のことが分かります。
Cプロファイルより、特定の膜種にのみ添加されている元素がある場合、Cの挙動からSiO2の各層位置関係を読み取ることが可能です。C(層位置)とF(拡散元素)のプロファイルを考察することで、上層に成膜したSiO2種は、中間層・下層のSiO2種と比較して、Fの拡散に対してバリア性が高いという情報を得ることができます。
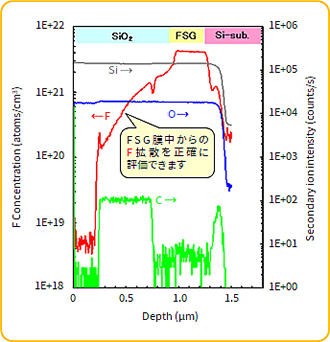
※元素の横の矢印は参照する縦軸を示しています
通常のSi膜には質量数28,29,30のSi同位体が天然存在比で含まれています。本事例におけるSi同位体超格子は、選択的に質量数28のみで成膜した層と、質量数30のみで成膜した層を交互に36層(約2nm/層)成膜し、構成されています。
試料ご提供元:慶応義塾大学理工学部 伊藤公平グループ 様
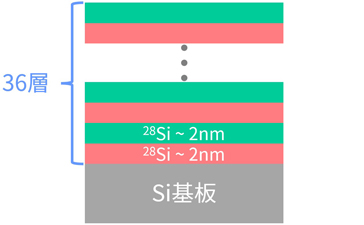
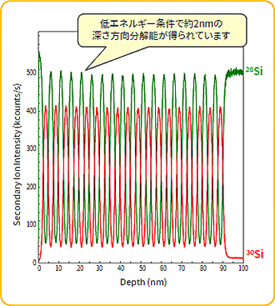
図より、28Si層と30Si層はプロファイル上で層として分離されていることが分かります。薄膜に適した低一次イオンエネルギーで測定することにより、約2nmの深さ方向分解能を得ることができます。一次イオンエネルギーは150eV~15keVの間で選択でき、低いほど高深さ方向分解能が得られます。ただし、深さ方向分解能と感度はトレード・オフの関係にあることから、分析試料の構造や元素分布に対して必要最低限の一次イオンエネルギーを選択する必要があります。
極浅い深さ分布をもつ試料の分析において、一次イオンエネルギーの選択は非常に重要となります。図は極表面にドーピングされたBの分布について、一次イオンエネルギー〔250/350/500(eV)〕の3水準で測定し比較した結果になります。
10nm付近に濃度変曲点を持ち、10nm以降のプロファイルは3水準で一致しています。一方、0~10nmには差異が生じていることが分かります。これは実際の分布形状に対する深さ方向分解能の不足度を示しています。10nm以降の緩やかな勾配に対しては、3水準のいずれの深さ方向分解能でも分布を捉えるのに十分であるためプロファイルは一致します。しかし、0~10nmは急峻な分布のため、350eV,500eVでは深さ方向分解能が足りず、一次イオンによる叩き込み(分解能関数)がプロファイルに反映されています。
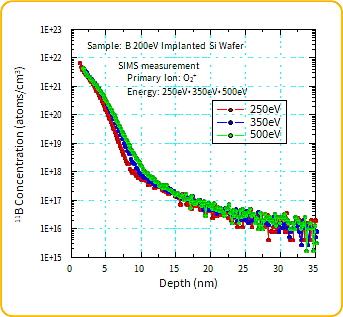
Siデバイスのn型ドーパント元素の一つにPがあります。デバイスの特性を決める非常に重要な元素ですが、SIMSにおいては30Si+H分子イオンと質量干渉を生じ検出下限値が上昇することが問題となります。これを解決するため、SIMSでは高質量分解能により、質量干渉成分と切り分けて評価することが可能です。
図はSi中にイオン注入された31Pについて、通常の測定(質量分解能:400)と高質量分解能での測定(4000)のプロファイル比較を示しています。通常の測定では0.4μm以降において2E17atoms/cm3程度でフラットに推移していることが分かります。これが質量干渉成分(30Si+H)であり、この濃度以下の31P分布を確認することができません。一方の高質量分解能では31Pを30Si+H 干渉成分と分離して捉えており、E14atoms/cm3オーダまでの分布を評価することが可能です。
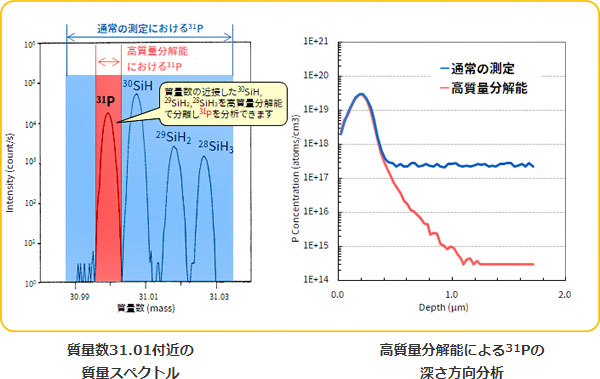
ウェーハ品だけでなく製品デバイスに対しても、パッケージ分解/エッチングにより基板を露出させ、SIMSにて基板の拡散層分布を調査することができます。図はパワーMOS製品において、基板中で結晶欠陥の原因になるとされているH(水素)・C(炭素)・N(窒素)・O(酸素)・F(フッ素)について評価した事例となります。C,OプロファイルはEpi. Siから基板にかけて勾配があり、コンタミネーションとして分布していることが分かります。
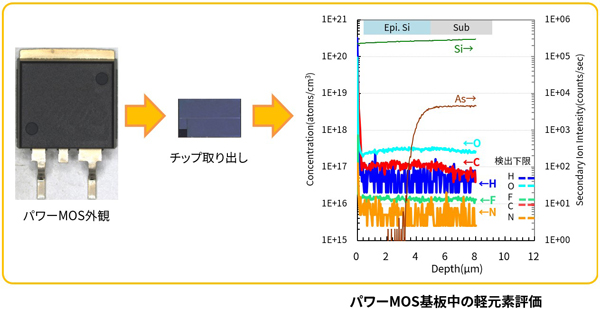
[ 更新日:2025/04/22 ]
依頼に関するお問い合わせ