半導体故障解析の手順Procedure of Semiconductor Failure Analysis
半導体デバイスの故障解析の手順として、故障発生状況の調査、外観観察および電気特性を取得し、故障メカニズムを推測します。次に、非破壊検査や故障特定を行なった後、さまざまな物理分析手法を用いて、故障メカニズムを解明します。
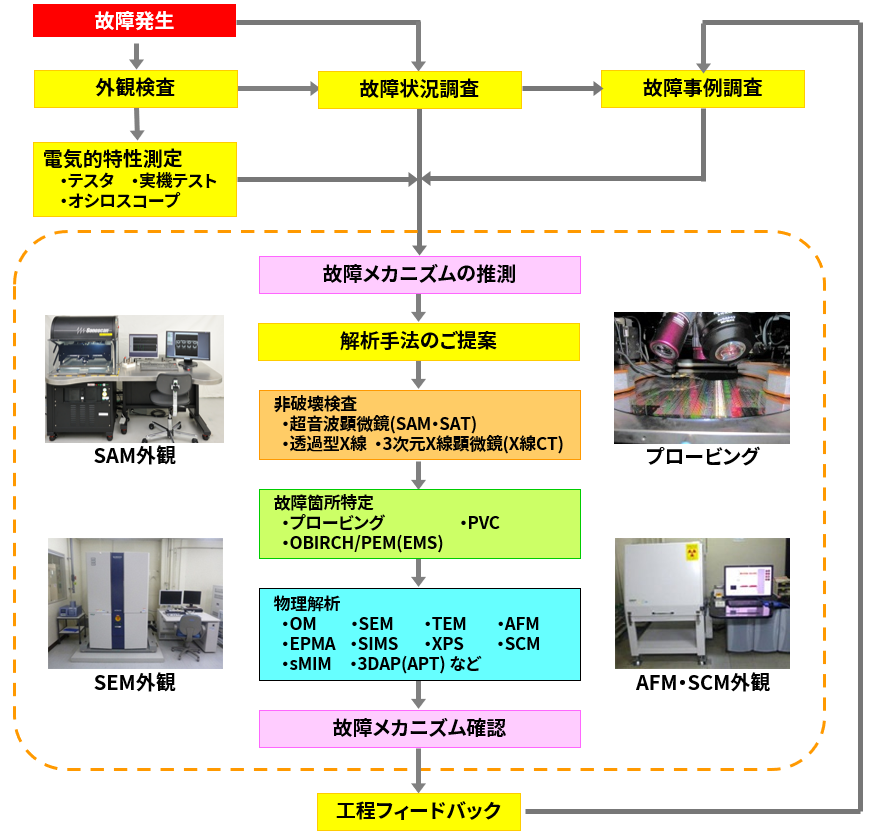
略語集はこちらから
不良品の故障モード(オープン・ショート・リーク電流増・動作不良)のみならず、履歴(製造ロット・在庫期間)、使用条件(電圧・熱ストレス・機械的ストレス)、環境条件(温度・湿度・場所)などの故障発生状況についてリストアップし、何らかの有意差がないか調査します。
たとえば、実装信頼性試験において、温度サイクル試験の前処理として実施した、はんだ耐熱性試験で発生する不良であれば、リフロー温度について調査することが重要です。
なお、半導体が基板に実装されている場合は、半導体を交換することで、故障原因が実装起因なのか半導体起因なのかを区別できます。しかし、不良品を交換することにより、実装の不良原因が失われてしまう可能性が高いので、事前に必ず外観検査やX線透過などの非破壊観察が必要です。
外観検査
実体顕微鏡や光学顕微鏡を用いて、パッケージのクラック、イオンマイグレーション、汚染や異物などの異常の有無を確認します。
この段階で、汚染が疑われる場合はEPMAで元素分析を行い、異物はRamanやFT-IRで分析します。
また、めっき膜厚の異常が疑われる場合はXRFで測定します。

電気特性
カーブトレーサ・半導体パラメータアナライザを使用して、端子間の電気的特性の測定を行います。
ICの故障解析では、必要に応じて評価用のテストプログラムを作成し、LSIテスタでDC特性、機能試験やマージン評価を行います。
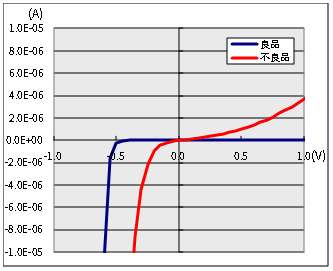
故障状況の調査結果、外観検査の結果、電気特性の測定結果を基に故障メカニズムを推測し、以降の解析手法を決定します。
X線透過観察・3次元X線(X線CT)顕微鏡観察
試料を分解する前に、X線による内部の透過観察を行い、ワイヤ・リードのオープンやショートの有無、異物の有無を確認します。
3次元X線顕微鏡(X線CT)で、試料内部を観察することで、さらに詳細に状況を把握することができます。基板やSiなどクラックの有無なども観察できます。
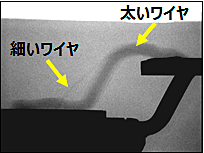
SAM観察
パッケージ内部の剥離やクラックが推測される場合は、SAMで観察します。
多段スタック品など、複数の界面を有する場合、透過観察で内部全体を観察する手法が有効です。
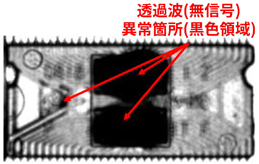
磁場顕微鏡
磁場顕微鏡で電流経路を推測することで、試料を開封せずに故障箇所を推測できる場合もあります。
試料を開封すると特性が変動する不良モードに有効です。
X線観察やSAMでパッケージ起因の不良であることが判明した場合は、断面研磨やイオンミリングで不良箇所を加工し、顕微鏡などで観察します。ボンディングワイヤの形状と接合状態の観察や、パッケージ内部のどの面で剥離が生じているかを特定することが故障メカニズムの推測に重要です。
特に剥離が原因である場合は、イオンミリングによる低ダメージ加工が必要です。
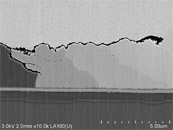
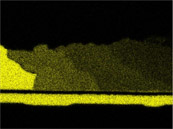

EDSによるCuボンディングの合金層分析
非破壊検査で異常が見つからず、チップ起因の不良が疑われる場合は、試料を開封した後、OBIRCH/PEM(EMS)で故障箇所を絞り込みます。
開封
開封する際は、半導体の種類や推測される故障メカニズムに適した手法を用いることが重要です。 開封には、薬液を用いて表面から開封する手法、モールド裏面からチップ裏面まで研磨する手法などがあります。
不適切な開封により、故障が再現せず原因不明に陥る可能性があり、注意が必要です。
表面から開封した場合は光学顕微鏡で、裏面から開封した場合は赤外顕微鏡で、溶融痕・腐食・断線やクラックなどの異常の有無を確認します。
OBIRCH/PEM(EMS)
開封後に電気特性が再現された状態で、OBIRCH/PEM(EMS)を用いて故障箇所の特定を試みます。
ICは、不良を再現させるために、特殊な治具とテストプログラムの作成が必要な場合があります。
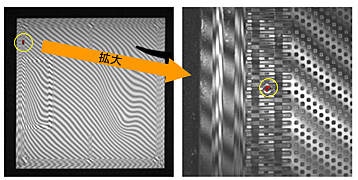
特定した故障箇所と故障状況の調査結果を基に故障メカニズムを推測し、物理解析の手法を選択します。ICの場合は、レイヤー解析を行なって不良箇所をさらに絞り込む作業が必要です。
形状に異常が推測される場合は、表面あるいは断面からSEMやTEMで観察し、EDSで元素分析を行います。さらに、必要に応じてTEM-EELSで結合状態を分析します。FIB/SEM法による3次元構造観察で、形状異常を立体的に観察することもできます。
拡散層の異常が推測される場合は、SCMで拡散状態を確認します。sMIMで観察することで拡散濃度の定量的な評価もできます。
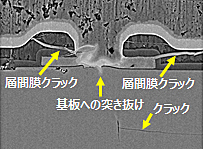
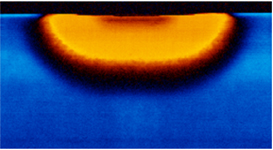
以上の解析で得た結果と、これまでに得た経験を基に故障メカニズムを解明します。
[ 更新日:2024/02/26 ]
依頼に関するお問い合わせ
電話番号・メールアドレス