走査電子顕微鏡(SEM)Scanning Electron Microscope
走査電子顕微鏡(SEM)は、試料の表面に電子線を照射して観察することで、微細な表面形状や組成、結晶方位を観察することができます。
走査電子顕微鏡(SEM)は、試料の表面に電子線を照射して観察することで、微細な表面形状や組成、結晶方位を観察することができます。
試料表面に電子線を照射すると、二次電子・反射電子・X線・光が発生します。SEMは、細く絞った電子線を試料表面に走査し、二次電子によって形状を、反射電子によって組成の違いを観察する装置です。
SEM: Scanning Electron Microscope (走査電子顕微鏡)
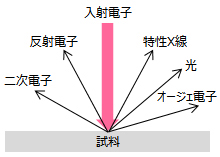
EDS: Energy Dispersive X-ray Spectroscopy (エネルギー分散型X線分光)
EBSD: Electron BackScatter Diffraction (Pattern) 〔電子後方散乱回折(パターン)〕
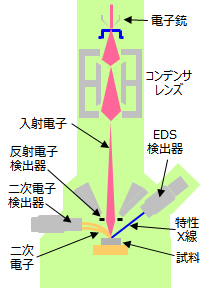
市販のLEDの金属電極断面をSEMで観察しました。低加速電圧で反射電子像を観察することにより、金属薄膜の結晶の状態を観察できています。
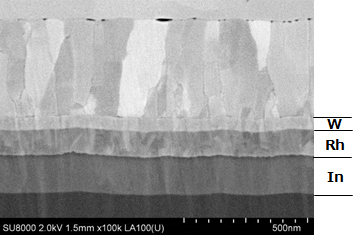
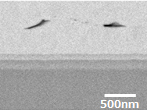



EDS分析では、加速電圧15kVでの分析が広く行われています。しかし、高い加速電圧では一次電子が試料内に数µmも侵入するため、X線が発生する領域が広がってしまい、分解能が下がります。
元素に応じて加速電圧を最適な値に下げることにより、高分解能でEDSマッピング分析を行うことができます。この分析では、50nmの金属薄膜のW,Rh,Inの各層を分離して観察することができます。

[ 更新日:2024/02/26 ]
依頼に関するお問い合わせ
電話番号・メールアドレス