低ダメージのイオンビーム加工Ion Beam Processing with Low Damage
集束イオンビーム(FIB:Focused Ion Beam)装置は、集束したイオンビームを試料に照射しスキャンさせることで、指定箇所の加工や観察が可能です。加工により発生したダメージ層は、TEM画像の像質を低下させるため、できるだけ減らすことが必要です。仕上げ加工時に、Gaイオンビームの低加速電圧化やArイオンビームなどを適用し、ダメージ層の低減を行います。
デバイスの微細化に伴い、 FIB加工で作製するTEM薄片試料の厚さが薄くなるほど、ダメージ層厚の割合が増し、TEM画像の像質に大きな影響を与えます。
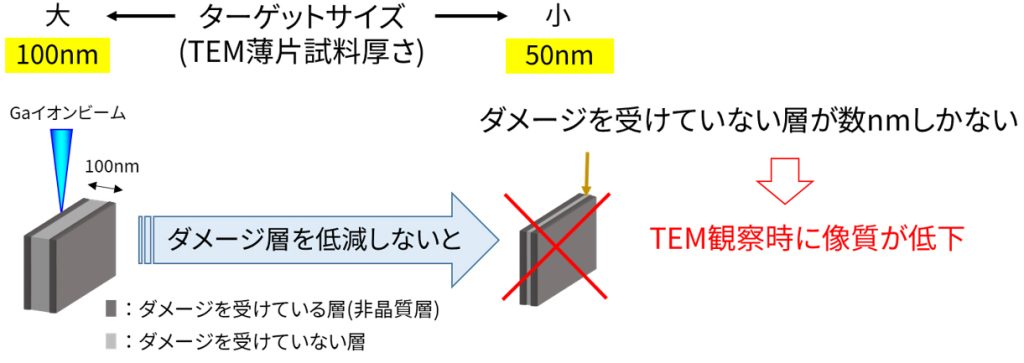
~ 加工によるダメージ層を低減するには ~
仕上げ加工時に、
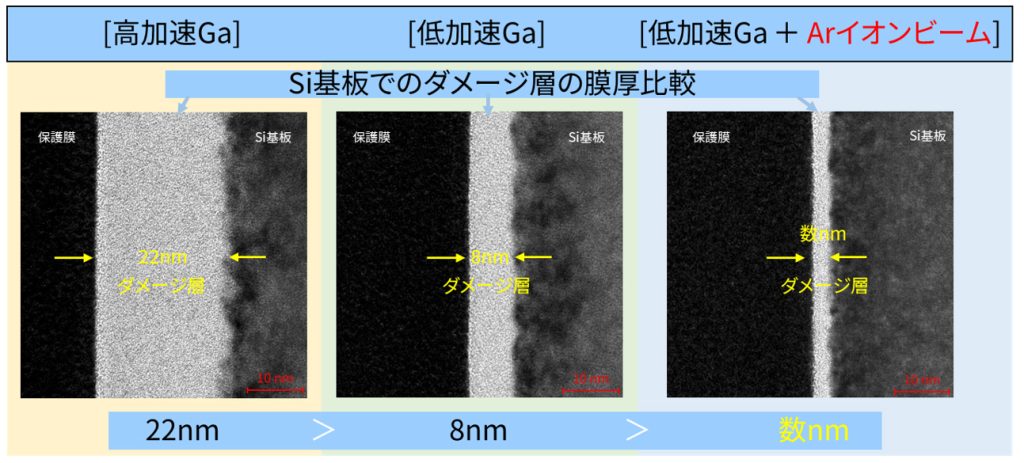
高加速Gaイオンビーム加工のみで仕上げた場合、ポリシリコンやSi基板などが非晶質化し、 TEM画像の 像質が低下しています。
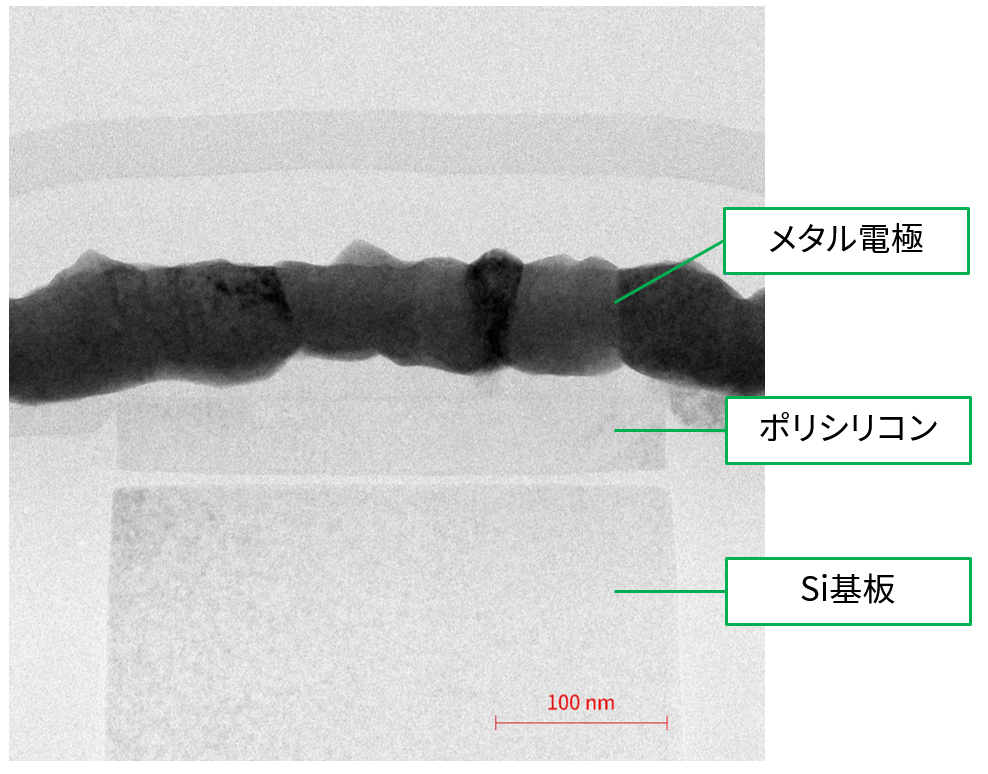
それに対し、低加速Gaイオンビーム加工後にArイオンビームで仕上げ加工した場合、ダメージ層が低減されることでポリシリコンやSi基板などの結晶性が保たれた像が得られています。
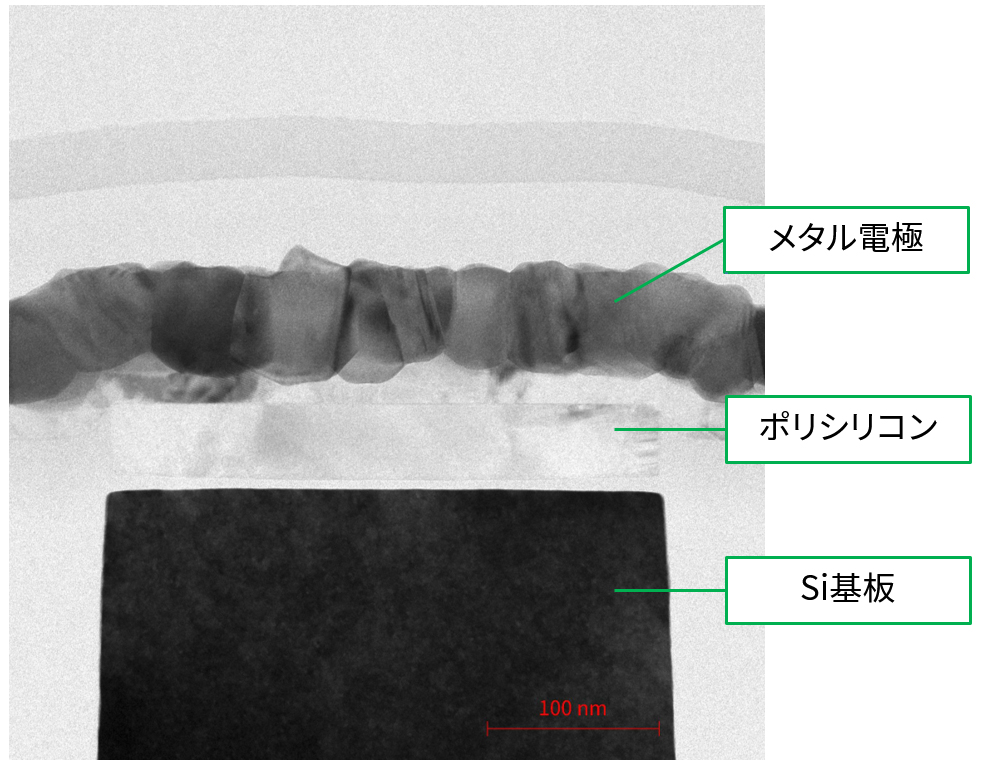
[ 更新日:2024/02/26 ]
依頼に関するお問い合わせ
電話番号・メールアドレス