ウェーハ表面・膜中・バルク中の金属汚染分析Trace Metal Contamination Analysis of Wafer Surface, Thin Layer and Bulk
半導体プロセスにおいて、デバイス性能に大きな影響を与える金属汚染のコントロールは重要です。当社では、汚染源・汚染領域など詳細に把握するための汚染評価手法として、ウェーハ最表層(平坦部・ベベルなどの局所)、膜中やバルク中などを切り分けた評価を可能にしました。
半導体プロセスにおいて、デバイス性能に大きな影響を与える金属汚染のコントロールは重要です。当社では、汚染源・汚染領域など詳細に把握するための汚染評価手法として、ウェーハ最表層(平坦部・ベベルなどの局所)、膜中やバルク中などを切り分けた評価を可能にしました。
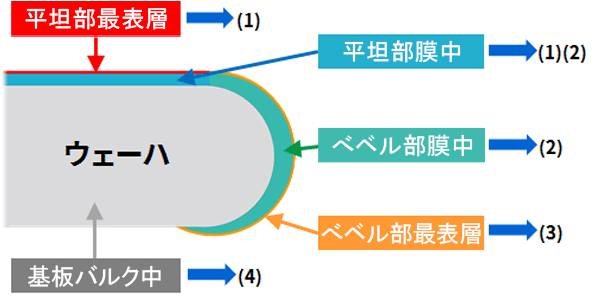

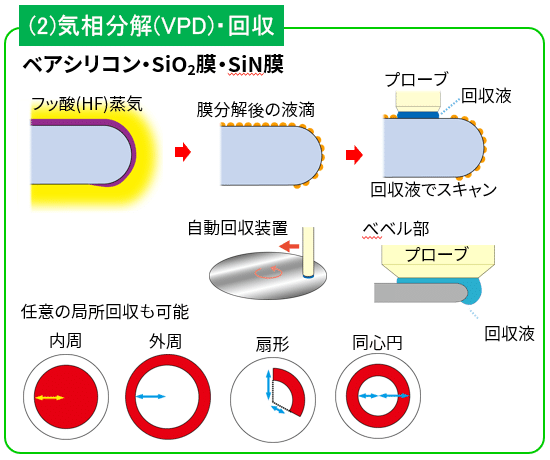
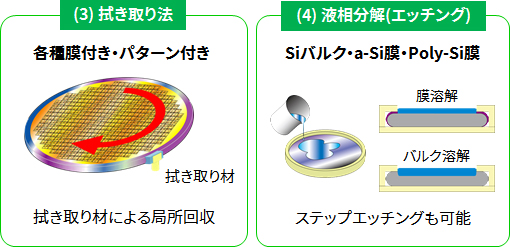

※試料の状態により変動する場合があります。
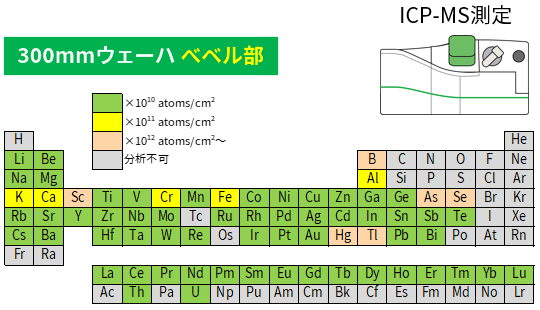
※試料の状態により変動する場合があります。
[ 更新日:2024/02/27 ]
依頼に関するお問い合わせ
電話番号・メールアドレス