浅い不純物注入プロファイルの精確な評価Accurate Evaluation of Impurity Implantation Profiles near Surface
SIMSによる深さ方向分析では、試料表面近傍の浅い領域においてスパッタ率が試料内部よりも高いために、クレーター深さから換算した場合の深さ軸は真値からのずれを生じます。当社では、『ISO 23812:2009』に準拠した、浅い深さ方向分布(Si)の深さ校正法の導入により、深さ軸が精確(高真度・高精度)な評価が可能になりました。
SIMSによる深さ方向分析では、試料表面近傍の浅い領域においてスパッタ率が試料内部よりも高いために、クレーター深さから換算した場合の深さ軸は真値からのずれを生じます。当社では、『ISO 23812:2009』に準拠した、浅い深さ方向分布(Si)の深さ校正法の導入により、深さ軸が精確(高真度・高精度)な評価が可能になりました。
TEM観察で各層の深さを校正された多層デルタドープ試料を使用することで、Si表面近傍の浅い領域における精確な深さ校正を行います。
多層デルタドープ試料の深さ方向分布(左下図)から、試料内部のスパッタ率、表面近傍での増速スパッタ効果による深さ方向分布のシフト距離を求め、式1に従って深さ軸を校正します。
右下図に、極表面に注入されたBの深さ方向分布を示します。 このように、表面付近の浅い不純物注入プロファイルについて精確な深さ評価が可能になります。

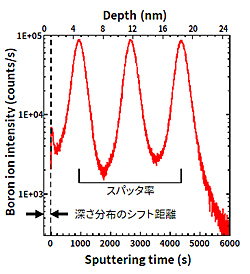

[ 更新日:2024/02/26 ]
依頼に関するお問い合わせ
電話番号・メールアドレス